CMOS: NOT Gate Design Process
By:
Anurag
Verma (17)
Garima
Verma (31)
PGDIE
42
1.
Introduction:
Complementary-metal-oxide-semiconductor (CMOS)
is a technology
used for constructing integrated
circuits
(ICs). CMOS technology is used in microprocessors, microcontrollers, static
RAM,
and other digital
logic circuits. CMOS is also
sometimes referred to as complementary-symmetry
metal–oxide–semiconductor (COS-MOS).The words
"complementary-symmetry" refer to the fact that the typical digital
design style with CMOS uses complementary and symmetrical pairs of p-type and n-type metal oxide semiconductor field
effect transistors (MOSFETs) for logic
functions like NOT,NAND,NOR etc. CMOS devices do not produce as much waste heat as other forms of
logic. CMOS also allows a high density of logic functions on a chip. It was
primarily for this reason that CMOS became the most used technology to be
implemented in VLSI chips. The phrase
"metal–oxide–semiconductor" is a reference to the physical structure
of certain field-effect
transistors,
having a metal gate electrode placed on top of an oxide insulator, which in
turn is on top of a semiconductor
material.
NOT gate is
implemented in CMOS by a combination of p-MOS and n-MOS as shown in Figure 1.2.
It is designed based on λ-based rules and stick diagram. The fabrication
process has been
discussed below for
CMOS inverter.
2.
Symbols
and Terminologies used in CMOS:
2.1.
Terminologies used for
CMOS
Symbol
|
Parameter
|
Value
|
Unit
|
Vcc
|
Supply Voltage
|
0 to 5
|
Volts
|
Vi
|
Input Voltage
|
0/5
|
Volts
|
Vo
|
Output Voltage
|
5/0
|
Volts
|
2.2.
Symbol of NOT Gate
Fig 1.1: Symbol for NOT Gate
2.3.
Truth
Table for NOT GATE
Input : A
|
Output: X
|
1
|
0
|
0
|
1
|
2.4.
CMOS
repesentation of NOT GATE
Fig 1.2: nMOS and
pMOS combined to form a NOT Gate
3.Design
Process
Sr.No.
|
Process
|
Diagram
|
1.
|
Ø Start with blank
wafer
Ø Build inverter from
the bottom up
Ø First step will be
to form the n-well
·
Cover
wafer with protective layer of SiO2 (oxide)
·
Remove
layer where n-well should be built
·
Implant
or diffuse n dopants into exposed wafer
·
Strip
off SiO2
|
|
2.
|
Ø Grow SiO2
on top of Si wafer
· 900 – 1200 C with H2O
or O2 in oxidation furnace
|
|
3.
|
Ø Spin on photoresist
· Photoresist is a
light-sensitive organic polymer
·
Softens
where exposed to light
|
|
4.
|
Ø Expose photoresist
through n-well mask
Ø Strip off exposed
photoresist
|
|
5.
|
Ø Etch oxide with
hydrofluoric acid (HF)
Ø Only attacks oxide
where resist has been exposed
|
|
6.
|
Ø Strip off remaining
photoresist using mixture of acids called piranah etch to
avoid resist
melting
|
|
7.
|
Ø n-well is formed
with diffusion or ion implantation
Ø Diffusion
·
Place
wafer in furnace with arsenic gas
·
Heat
until As atoms diffuse into exposed Si
Ø Ion Implantation
·
Blast
wafer with beam of As ions
·
Ions
blocked by SiO2, only enter exposed Si
|
|
8.
|
Ø Strip off the
remaining oxide using HF
Ø Back to bare wafer
with n-well
Ø Subsequent steps
involve similar series of steps
|
|
9.
|
Ø Deposit very thin
layer of gate oxide
·
<
20 Å (6-7 atomic layers)
Ø Chemical Vapor
Deposition (CVD) of silicon layer
·
Place
wafer in furnace with Silane gas (SiH4)
· Forms many small
crystals called polysilicon
· Heavily doped to be
good conductor
|
|
10.
|
Ø Use same lithography
process to pattern polysilicon
|
|
11.
|
Ø Use oxide and
masking to expose where n+ dopants should be diffused or implanted
Ø N-diffusion forms
nMOS source, drain, and n-well contact
|
|
12.
|
Ø Pattern oxide and
form n+ regions
Ø Self-aligned process where gate blocks
diffusion
Ø Polysilicon is
better than metal for self-aligned gates because it doesn’t melt during later
processing
|
|
13.
|
Ø Historically dopants
were diffused
Ø Usually ion
implantation today
Ø But regions are
still called diffusion
|
|
14.
|
Ø Strip off oxide to
complete patterning step
|
|
15.
|
Ø Similar set of steps
form p+ diffusion regions for pMOS source and drain and substrate contact
|
|
16.
|
Ø Now we need to wire together
the devices
Ø Cover chip with
thick field oxide
Ø Etch oxide where
contact cuts are needed
|
|
17.
|
Ø Sputter on aluminum
over whole wafer
Ø Pattern to remove
excess metal, leaving wires
|
4.
λ-based Design Rules for CMOS Fabrication
Rule
number Description λ-Rule
Active area rules
R1 Minimum active
area width
3λ
R2 Minimum active
area spacing
3λ
Polysilicon rules
R3 Minimum poly
width
2λ
R4 Minimum poly
spacing 2λ
R5 Minimum gate
extension of poly over active
2λ
R6 Minimum
poly-active edge spacing
1λ
(poly
outside active area)
R7 Minimum
poly-active edge spacing
3λ
(poly
inside active area)
Metal rules
R8 Minimum metal
width 3λ
R9 Minimum metal
spacing 3λ
Contact rules
R10 Poly contact size
2λ
R11 Minimum poly
contact spacing 2λ
R12 Minimum poly
contact to poly edge spacing
1λ
R13 Minimum poly
contact to metal edge spacing 1λ
R14 Minimum poly
contact to active edge spacing 3λ
R15 Active contact
size
2λ
R16 Minimum active
contact spacing 2λ
(on
the same active region)
R17 Minimum active
contact to active edge spacing 1λ
R18 Minimum active
contact to metal edge spacing 1λ
R19 Minimum active
contact to poly edge spacing 3λ
R20 Minimum active
contact spacing 6λ
(on
different active regions)
5.
STICK Diagram:
Fig 1.4: λ based layout diagram for NOT Gate
6.
Equipments used in Manufacturing:
Sr.No.
|
Process
|
Equipment Used
|
1.
|
Evaporation
(Deposition)
|
Vacuum
Pump
|
2.
|
Photolithography
|
Stepper
and Photo Mask
|
3.
|
Etching
|
Reactive
Ion Etching (RIE) System
|
4.
|
Diffusion
|
Heating
in Quartz Tube at 900-1100 degree C
|
5.
|
Ion
Implantation
|
Ion
Beams of purified Dopants
|
Fig 1.5:Testing procedure for CMOS
5.1
Designing the logic
The
objective of the design procedure is to produce a CMOS NOT Gate. In this
specification what operation the gate has to perform is done. Inputs and
outputs the Gates are decided.
5.2
Synthesizing the gates
The
objective of the synthesis procedure is to generate a gate-level net-list
equivalent to the logic created in the design procedure.
5.3
Laying out the chip
The
objective of the layout procedure is to generate the actual geometries that
form the masks to build the chip. The layout process defines the actual
patterns that are created on the chip. The vendor uses powerful CAD tools to
determine how to actually arrange the CMOS wafer then simulator is used to verify
that the design’s function and timing are correct before fabricating the chip.
5.4
Fabricating the prototypes
The
objective of the fabrication process is to manufacture prototype ICs. Vendors
produce prototypes before mass production for speed and quality control. They
run two or three wafers of the chip so that if something goes wrong on one
wafer, the other wafers may still yield good parts. Turnaround time for
prototypes is four to eight weeks. Once the prototype chips have been
fabricated and delivered, the next task is to verify their functionality and
working.
5.5
Verifying the prototypes
The
objective of the verification process is to ensure that the prototype ICs meet
all their functional, timing, environmental requirements and also meet the
needs of the system they were designed to be part of. The prototype chips need
to be evaluated quickly because the process will be delayed if the ASIC has
problems. If verification testing proves that the chip meets all of its
specifications and functionality, then the process of developing the ASIC is
completed. The design is released for production. However, problems often arise
during verification. Sometimes they can be tolerated or can be worked around in
software; if not iteration of the design has to be performed.
5.6
Iterating the design
The
objective of iteration process is to revise the design until the prototype
chips pass the verification process. CAD tools and vendors are so good these
days, first set of prototypes often yields good parts. However, when bugs do
show up, they are eliminated by revising the design and prototyping the chip
again. This process is known as iterating the chip, or stepping the chip. What
it means is that we return to the beginning of the design procedure and do it
all over again. Subsequent iterations can be accomplished much more quickly
than the first pass because we can focus on just the few problems that require
fixing. Finally when the prototype passes the verification process, CMOS NOT
Gate development process is completed.















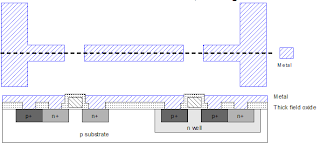




No comments:
Post a Comment